 GaN-HEMT作製の様子
GaN-HEMT作製の様子
私たちの世界は、目に見えない電波を活用した様々な電子機器により、豊かで便利かつ安心安全な生活を実現しています。スマートフォンやWi-Fiに代表される無線通信、気象や防衛向けレーダーなど、どれも現代社会には欠かせないものですが、これらの機器では通信距離や探知距離をより長くするために、電波送信用パワーアンプの更なる高出力化が求められています。
今回、無線通信やレーダーに広く用いられるX帯と呼ばれる周波数領域のパワーアンプにおいて、バンドギャップが広く堅牢な構造を有する窒化ガリウム(以下、GaN)材料系を用いた高電子移動度トランジスタ(以下、HEMT*1)に用いられる、保護膜と呼ばれる絶縁膜の高品質化を行いました。その結果、31W/mm(ワットパーミリメートル*2)という世界トップの出力密度を実現しました。これはGaN材料系を含む固体電子素子で最高の数値*3であり、およそ20年ぶりにトップデータの更新を実現しました。
・本技術の詳細は、学術論文誌「IEEE Electron Devices Letters」に掲載されています。![]()
- *1High Electron Mobility Transistor
- *2トランジスタのゲート幅1mmあたりの出力電力
- *3当社調査に基づく
従来の課題
パワーアンプの出力を向上させるためには、トランジスタの電流値と動作電圧を増加させる必要があります。このため当社はGaN系HEMTにおける電子供給層や障壁層と呼ばれる電子を発生させる層として、従来の窒化アルミニウムガリウム(以下、AlGaN)に替わる窒化インジウムアルミニウムガリウム(以下、InAlGaN)を大電流と高電圧を両立させる有力な候補として積極的に提案してきました(図1)。しかしながら、このInAlGaN材料は、構成元素のIn(インジウム)とN(窒素)の結合が弱いことによる半導体表面の劣化が懸念されてきました。
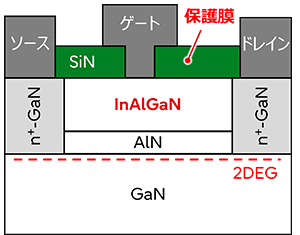 図1.InAlGaNを用いたHEMTの断面図
図1.InAlGaNを用いたHEMTの断面図
開発した技術
今回、熱CVD*法と呼ばれる、熱分解による生成物や化学反応によって薄膜を形成する手法で成膜した窒化シリコン(以下、SiN)を、半導体表面の保護膜として用いました。従来広く用いられているプラズマCVD法に比べ、熱CVD法では下地劣化の起因となる、荷電粒子を多く含むプラズマを用いません。そのため、半導体表面の劣化を大幅に抑制することが可能となります(図2)。この熱CVD法で成膜したSiNをInAlGaN系HEMTに適用することで、電流値の更なる増加、電流コラプスと呼ばれる電子トラップ起因の減少、耐圧の増加を両立することができました。これにより、X帯パワーアンプとして、90Vという高い動作電圧にて31W/mmのパワー密度を得ることに成功しました(図3・4)。
- *CVD:Chemical Vapor Deposition
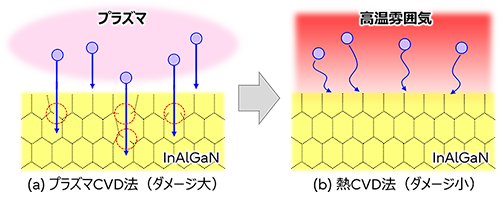 図2.成膜方法によるダメージの違い
図2.成膜方法によるダメージの違い
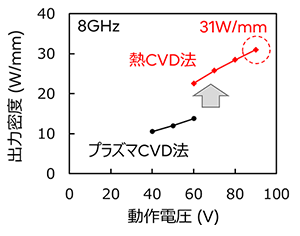 図3.熱CVD法適用による出力密度の向上
図3.熱CVD法適用による出力密度の向上
 図4.X帯パワーアンプのベンチマーク
図4.X帯パワーアンプのベンチマーク
今後について
今後は本技術の実用化を目指し、高効率化やモジュール化を進めるとともに、信頼性の評価を進めてまいります。
関連情報
・高電子移動度トランジスタ(High Electron Mobility Transistor)がIEEEマイルストーンに認定(2019年12月18日 プレスリリース)
・世界最高効率の省電力マイクロ波パワーアンプを開発(2021年3月2日 技術トピックス)
・世界初!新材料窒化アルミニウムを用いた高出力パワーアンプの開発に成功(2022年1月25日 技術トピックス)
・6G高速通信に向けた世界最高効率のJ帯パワーアンプを開発(2023年2月27日 技術トピックス)
・6G大容量通信向けサブテラヘルツ帯アレイアンテナにおけるビーム制御に成功(2024年2月22日 TECH BLOG)
本件に関するお問い合わせ
富士通研究所 デバイス&マテリアル研究センター
contact-gan@cs.jp.fujitsu.com



