世界初!新材料窒化アルミニウムを用いた
高出力パワーアンプの開発に成功
2022年1月25日
通信基地局やレーダー等の電波送信部には、高出力な電波を発信することが可能な、窒化ガリウム(GaN)高電子移動度トランジスタ(HEMT)が広く利用されています。将来、通信量の増大などがますます加速するため、現在のGaN-HEMTを凌駕する次世代パワーアンプの実現が期待されています。
今回、次世代半導体材料として期待される窒化アルミニウム(以下、AlN)を利⽤した⾼出⼒HEMTの開発に世界で初めて成功しました。
半導体材料の中で最大の絶縁耐圧を有するAlNを利用した高出力HEMTの開発に取り組み、AlN基板上に形成するHEMT構造内部の結晶格子の歪みを低減することで、トランジスタ内部を走行する電子のスムーズな移動を可能にしました。レーダー等に広く利用されるX帯と呼ばれる10 GHz周辺の周波数で15.2 W/mmというAlN材料系として、世界最高の高出力動作に成功しました。
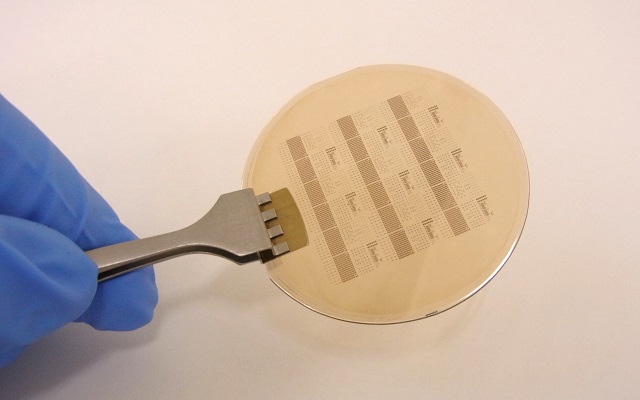 2インチAlN基板上に作製したHEMT素子
2インチAlN基板上に作製したHEMT素子
本研究成果は次世代半導体材料の一つであるAlNを利用した新構造の可能性を示すものです。今後はAlNやAlGaNを利用した最適構造にすることで、次世代パワーアンプとして、無線通信距離やレーダー探知距離を飛躍的に伸ばしていくことが期待できます。
本技術の詳細は、論文誌「Applied Physics Express」![]() および「Electron Device Letters」
および「Electron Device Letters」![]() に掲載されています。
に掲載されています。
開発の背景
私たちの生活は電波を利用した様々な電子機器に支えられています。例えば遠方の物体を検知するレーダーは電波を利用しており、社会の安心・安全を担保する安全保障分野のほか、気象分野など広く活用されています。さらに、私たちがより直接的に電波を利用しその恩恵を享受しているのがスマートフォンやWi-Fiに代表される無線通信分野であり、現代社会の生活インフラとして欠かせないものとなっています。これらのレーダーや無線通信機器の要となるのが電波送信部であり、そこに半導体を利⽤したパワーアンプが用いられています。レーダー分野では探知できる距離を延ばすこと、また通信分野では通信距離を⻑く確保することが求められるため、更に高出力な電波を発信するパワーアンプの実現が期待されています。
従来の課題
次世代半導体材料として期待されるAlNは半導体材料の中で最大のバンドギャップを誇り、従来の半導体材料であるシリコン(Si)はもとより、高耐圧材料として知られるGaNをも凌駕する絶縁耐圧を有しています。既に論文等では、AlNやAlGaNをHEMTに利用し、トランジスタの破壊耐圧を高くすることで、GaN-HEMTを超える高電圧動作が実証されています。しかし、AlNはGaNと結晶を構成する原子の間隔が異なることから、GaN-HEMTに直接AlNを導入すると、結晶格子サイズの差に起因して結合の断裂(欠陥)や、結晶格子の歪みが生じていました(図1)。
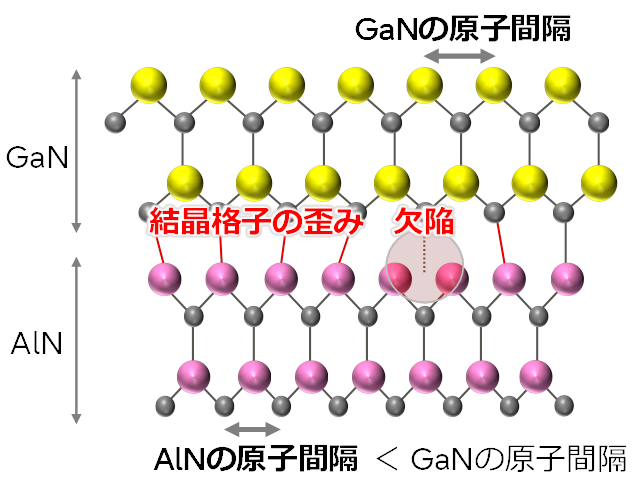 図1 GaNとAlNの間に生じる結晶欠陥と結晶格子の歪み
図1 GaNとAlNの間に生じる結晶欠陥と結晶格子の歪み
結晶格子の欠陥や歪みは、トランジスタ内部を走行する電子にとっての障害物となり、AlNやAlGaNを利用したHEMTによる大電流動作の課題でした。トランジスタの出力は電流と電圧の掛け合わせで決まることから、これまで動作電圧の増加だけでは、AlNやAlGaNを利用したHEMTの高出力動作を実現できませんでした(図2)。
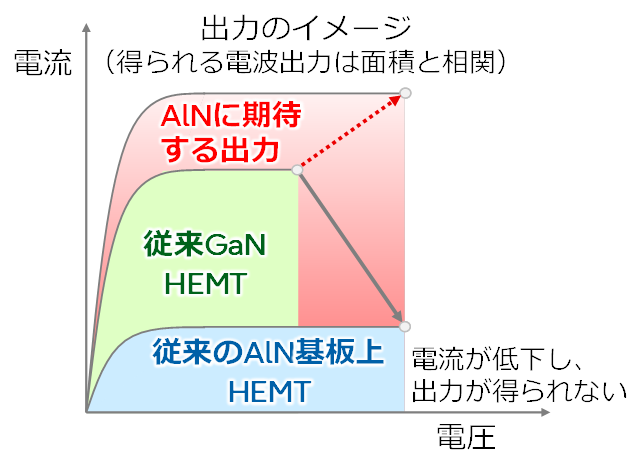 図2 トランジスタ出力のイメージ図
図2 トランジスタ出力のイメージ図
(高電圧動作と大電流動作の両立が必要)
開発した技術
今回、半導体材料の中でも最大の絶縁耐圧を有するAlN基板を採用しました。トランジスタ内部における電子のスムーズな移動を実現するため、AlGaNバッファ層を用いて結晶格子の歪みを制御する技術を開発しました。AlGaNバッファ層の膜厚、成長速度、温度などの結晶成長条件を最適化することで、HEMT構造中の欠陥や歪みを低減し、AlNを利用したHEMTの高出力動作に成功しました。
AlN基板上にGaN結晶を直接形成すると、原子間隔の差に起因して結晶中に欠陥や歪みが発生します。この結晶欠陥は近くを走行する電子の運動に影響を与えるため、電子のスムーズな移動を妨げます。また、結晶格子の歪みは原子位置を本来の位置から動かすこととなるため、近くを走行する電子の直線的な移動を妨げ、大電流動作を阻害する要因となります(図3)。
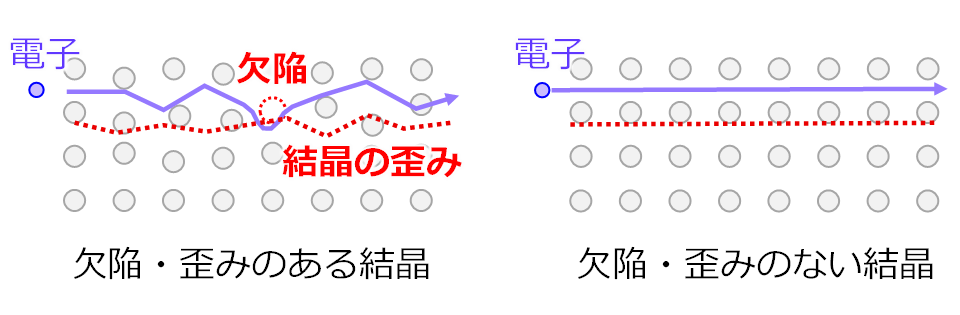 図3 欠陥・歪みが電子のスムーズな移動を阻害
図3 欠陥・歪みが電子のスムーズな移動を阻害
そこでAlN基板とGaN結晶の間にAlGaNバッファ層を挿入し、欠陥の発生を抑制しました(図4)。さらに、成長温度や原料供給濃度等の結晶成長条件を緻密に制御することで結晶格子の歪みを低減し、GaNチャネル層中のスムーズな電子輸送の実現に成功しました。
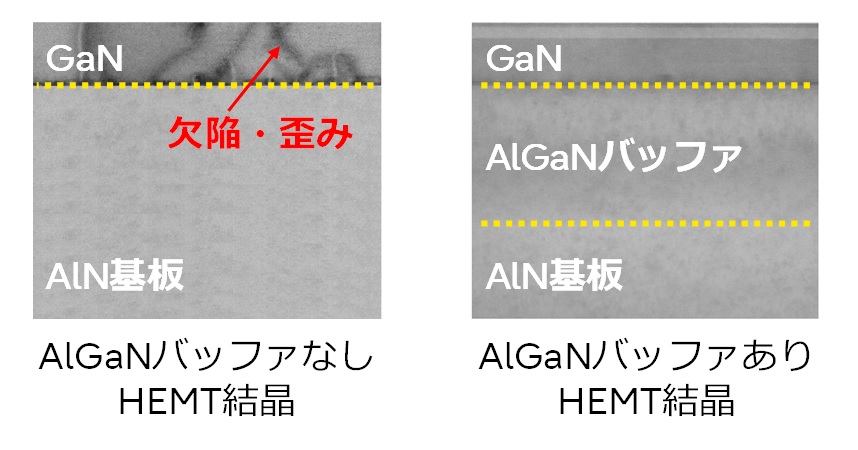 図4 従来のHEMT結晶と開発したAlN基板上HEMT結晶の断面図(電子顕微鏡像)
図4 従来のHEMT結晶と開発したAlN基板上HEMT結晶の断面図(電子顕微鏡像)
開発したAlGaNバッファ構造をAlN基板上HEMTに適用することで大電流動作と高電圧動作の両立が可能となりました。開発したパワーアンプのX帯での出力特性を評価した結果、AlN基板上HEMTにおける世界最高出力密度 15.2 W/mmを達成しました(図5)。
 図5 AlN基板上HEMTの高出力動作
図5 AlN基板上HEMTの高出力動作
本技術により、高周波パワーアンプの高出力化が可能となり、長距離無線通信や様々なレーダーの探知距離延伸が期待できます。
今後はAlGaNバッファ構造による結晶格子の歪みの更なる低減や、最適なGaNチャネル構造の検討を推進し、AlN基板上でのHEMTの更なる高出力化に向けて開発を継続していきます。
本研究の一部は、防衛装備庁が実施する安全保障技術研究推進制度(JPJ004596)の支援を受けて実施されました。
開発者コメント
・デバイス&マテリアル研究センター 先端材料技術プロジェクト 矢板 潤也 研究員
「本研究を進めるにあたり、様々な関係者の協力の下、AlNを利用したパワーアンプの高出力化という高い目標を達成することができました。このような半導体の高性能化は、地球上の温室効果ガスの排出量と吸収量・除去量を均衡させるカーボンニュートラルといった国際目標に役立つキーテクノロジーとしても期待されています。よりサステナブルな世界の実現へ向けて、さらなる高性能化や新材料を利用した新しい物理現象の究明を目指し、今後もより一層励んでいきます。」
 開発チーム:左から矢板 潤也 研究員、尾崎 史朗 シニアリサーチャー、小谷 淳二 プロジェクトマネージャー
開発チーム:左から矢板 潤也 研究員、尾崎 史朗 シニアリサーチャー、小谷 淳二 プロジェクトマネージャー
関連情報
・世界最高効率の省電力マイクロ波パワーアンプを開発 ![]() (2021年3月2日 技術トピックス)
(2021年3月2日 技術トピックス)
・高電子移動度トランジスタ(High Electron Mobility Transistor)がIEEEマイルストーンに認定 ![]() (2019年12月18日 プレスリリース)
(2019年12月18日 プレスリリース)
本件に関するお問い合わせ
EEA (European Economic Area) 加盟国所在の方は以下からお問い合わせください。
Ask Fujitsu
Tel: +44-12-3579-7711
http://www.fujitsu.com/uk/contact/index.html![]()
Fujitsu, London Office
Address :22 Baker Street
London United Kingdom
W1U 3BW



