ポスト5G基地局へ向けた
高周波帯アンプ一体型アレイアンテナ実装技術の開発
2025年1月6日
English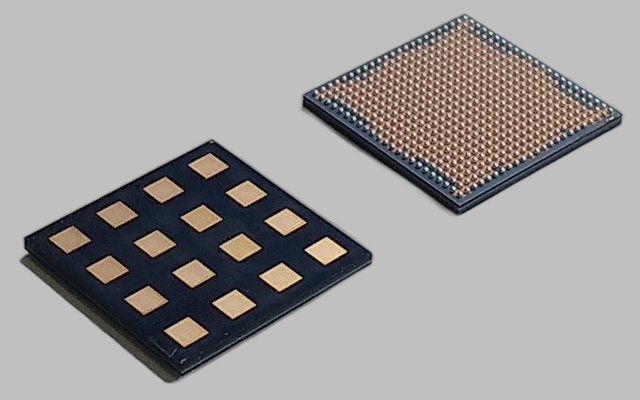
スマートフォンなど通信機器の利用が増え続け、人が密集する場所ではトラフィック集中による通信の混雑が発生することがあります。快適な通信速度維持のためには、現在5Gで主に使われている周波数帯のSub6帯だけでは、周波数リソースが不足することが予想されています。そのため、広い帯域を確保可能で、高い周波数を持つミリ波帯を利用した、通信の高速化かつ大容量化が期待されています。
今回、北米で周波数割り当て済みで5Gのミリ波帯の中でも高い周波数に位置する47GHz帯に着目し、波長の短いミリ波の特長を活かした高速かつ大容量の小型無線送受信部モジュールを開発しました。特に、高集積化に伴う内蔵ICの自己発熱問題に対して、パッケージの熱抵抗0.3 K/W以下という高放熱特性を実現し、データ通信の品質の指標となる送信変調精度(以下、EVM)についても3.9%を達成しました。これは、3GPP*テスト規格の要求値(4.5%未満)を満たしており、ミリ波を用いた小型なポスト5G基地局実現に向けた大きな前進となります。
- *3GPP:移動通信システムの仕様の検討や策定を行う国際的な標準化団体
従来の課題
ミリ波帯は、距離減衰が大きく伝搬距離が短いことと、直進性が高く障害物に弱いという特性を持っています。このため、ミリ波帯で堅牢かつ信頼性の高い通信を実現するには、多素子アクティブ・フェーズドアレイ構造を用いたBeam Forming技術を活用し、放射強度を高めることで距離減衰の影響を軽減させることが有効です。また、障害物の影響を受けやすいという課題に対しては、Radio Unit間の距離を短くし、数多く設置するために、小型で高信頼かつ低価格のRadio Unitが必要です。
現在、28GHz帯のミリ波では、Antenna on Board(アンテナ素子をプリント基板表面に、Beam Forming ICを裏面に実装)を用いた小型化が進められていますが、高周波化に伴う信号配線損失による効率低下が課題となっています。この配線損失を軽減するための技術として、アンテナとパッケージを一体化することでさらなる小型化を実現するAntenna-in-Packageが有効です。しかし、多素子アクティブ・フェーズドアレイ構造を実現するには、小型で高集積のBeam Forming ICの開発と、高集積化に伴う自己発熱問題への対応が課題でした。
開発した技術
5Gのミリ波帯の中でも高い周波数に位置し、波長が短いため高集積化が難しいとされる47GHzに対して、偏波多重に対応した小型で低消費電力の32チャンネルBeam Forming ICと、再配線層(以下、RDL)を用い、放熱性能向上のためフェイスアップ構造を採用した小型Antenna-in-Packageモジュールを開発しました。
低コストで量産性に優れ、デジタル技術との親和性が高い55nmのCMOS技術と、双方向周波数変換器および中間周波数(IF)移相器を採用することで小型化を実現し、チップサイズは9.13 mm×9.48 mmと、32チャンネル集積Beam Forming ICとしては最小クラスとなりました。水平・垂直偏波それぞれ16チャンネルのトランシーバと、SPI(Serial Peripheral Interface)インターフェースによるビーム制御機能を搭載することで、MIMO(Multiple Input Multiple Output)やBeam Formingに対応しています(図1)。
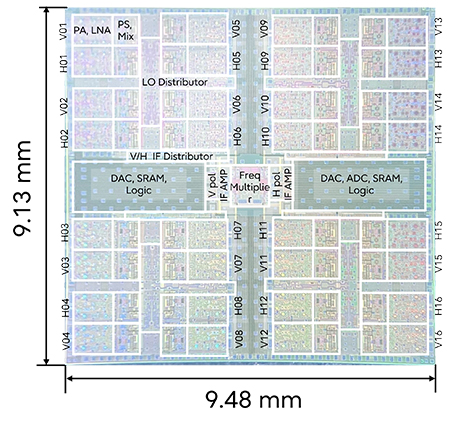 図1. 47GHz帯偏波多重対応32チャネルBeam Forming IC
図1. 47GHz帯偏波多重対応32チャネルBeam Forming IC
5G NR規格(256QAM変調、100MHz帯域幅)に基づいたOver The Air環境下での送信EVM評価において、水平偏波のみ放射時のEIRP(等価放射電力)+30.7 dBmで、送信EVM 3.9%を達成し、3GPPテスト規格の要求値(4.5%未満)を満たしています。
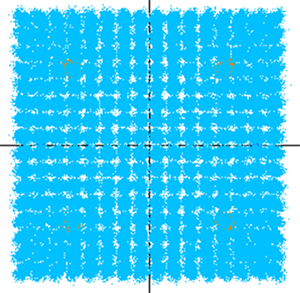 図2. Over The Air環境下におけるAntenna-in-Packageモジュールの256QAMコンスタレーション
図2. Over The Air環境下におけるAntenna-in-Packageモジュールの256QAMコンスタレーション
(コンスタレーション:通信の正確性を視覚化したもので、点がきれいな格子状に並ぶ状態は良好な通信品質を示す)
さらに、Antenna-in-Package開発においては、チップの回路面を上向きに配置するフェイスアップ構造を採用しました。アンテナ近くに送受信回路を配置することで配線損失を軽減し、チップ背面に接触する半田ボールがヒートスプレッダーとして機能することで放熱性能を向上させています。この構造によって、優れた放熱特性と低配線損失を実現しました。この結果、熱抵抗を0.3 K/W以下に抑え、小型な高集積Beam Forming ICの自己発熱による特性劣化を抑制し、信頼性を大きく向上させることが可能となりました(図3、4)。これは、ミリ波を用いたポスト5G基地局による超高速通信、超低遅延、多数同時接続の実現に向けた大きな前進となります。
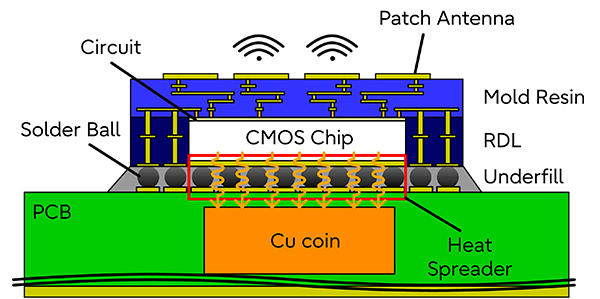 図3. フェイスアップ構造 RDL Antenna-in-Package断面構造図
図3. フェイスアップ構造 RDL Antenna-in-Package断面構造図
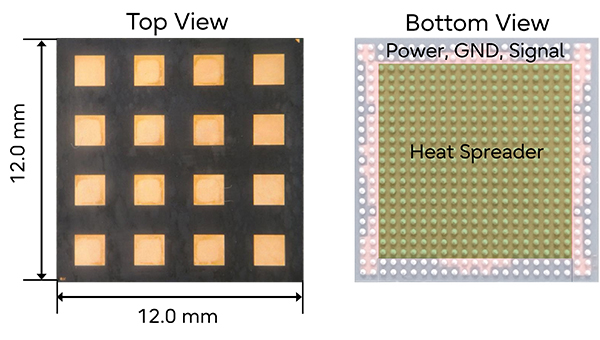 図4. 4×4 47GHz RDL Antenna-in-Package
図4. 4×4 47GHz RDL Antenna-in-Package
本開発技術は、マイクロ波集積回路に関するヨーロッパ最大の国際会議であるEuMIC 2024(European Microwave Integrated Circuits Conference)にて発表を行いました。
A compact 47 GHz Band 2×16ch CMOS Phased Array Transceiver Chip with Bi-directional IF Phase Shifter and IQ Mixer![]()
『この成果は、国立研究開発法人新エネルギー・産業技術総合開発機構(NEDO)の「ポスト5G情報通信システム基盤強化研究開発事業」(JPNP20017)の委託事業の結果得られたものです。』
今後について
今後は本技術の実用化を目指し、高効率化やモジュール化を進めるとともに、信頼性の評価を進めてまいります。



